2025年6月2日
株式会社KOKUSAI ELECTRIC(代表取締役 社長執行役員:塚田 和徳、本社:東京都千代田区)は、横浜国立大学 総合学術高等研究院 半導体・量子集積エレクトロニクス研究センター ヘテロ集積研究拠点長 井上史大准教授とそのチームとの共同研究により、高熱伝導な新規接合材料「ALD-Al₂O₃」を用いた300mmウェーハの成膜に成功しましたので、お知らせいたします。
概要
本研究は、次世代の半導体3Dデバイス構造に不可欠な「Backside Power Delivery Network(以下、「BSPDN」)」や「Reconstructed Die-to-Wafer(D2W)Hybrid Bonding」への適応をめざしており、従来材料での熱拡散性の不足、接合プロセスの低コスト化、十分な接合強度の確保といった課題を克服するために実施されたものです。
今回の研究対象であるALD-Al₂O₃は、従来のSiO₂やSiCNに比べて高い熱伝導率を有しており、またCMPやプラズマ活性化を必要としない直接接合を可能とします。これにより、工程の簡略化および大幅なコスト削減が見込まれ、BSPDNなどの3D実装構造において、信頼性の高いキャリアウェーハ構成が実現可能となります。熱放散課題解決の足掛かりとなれば、今後の3Dヘテロ集積構造における高密度かつ省エネルギー化が見込め、さらなる半導体エレクトロニクスの発展に寄与するものとなります。
なお、この研究は2025年3月12日付で発表した「JST研究成果最適展開支援プログラム(A-STEP)産学共同JPMJTR241A 」によって執り行われたもので、この成果は6月2日(月)から6月5日(木)に韓国・釜山で開催される半導体配線技術に関する最大の国際会議IEEE 28th International Interconnect Technology Conference (IITC2025)において、当社および横浜国立大学の共同で発表されます。
研究の詳細
本研究では、300mmシリコンウェーハ上に原子層堆積(ALD)法により5nm厚のAl₂O₃膜を成膜し、CMPおよびプラズマ処理を一切行わずに直接接合を実現しました。ボイド(空孔)フリーの接合界面が形成されたことを透過電子顕微鏡および超音波観察で確認しました。接合強度は、横浜国立大学が主導し国際規格化を進めている不活性雰囲気下でのダブルカンチレバー法(DCB)によって評価され、十分な強度が得られたことを示しました。さらに、TDS(昇温脱離)を用いた解析から、Al₂O₃膜には成膜温度に依存した水分およびオープンスペース量の違いがあり、これらが接合界面のボイド形成や接合強度に大きく影響することが明らかとなりました。膜中の水分量が過多な場合、接合強度の飽和や空孔形成を引き起こす一方、適切な水分は接合形成に寄与することも確認されています。また、ALD-Al₂O₃膜は従来のSiO₂よりも高い熱伝導率を記録しました(図2)。これにより、接合界面における熱抵抗の低減が可能となり、BSPDN構造の熱マネジメント向上に寄与することが期待されます。本技術は、従来の接合材料に対する強力な代替案となると同時に、3D実装における熱的・機械的課題の克服に資する有望なプロセス基盤となります。
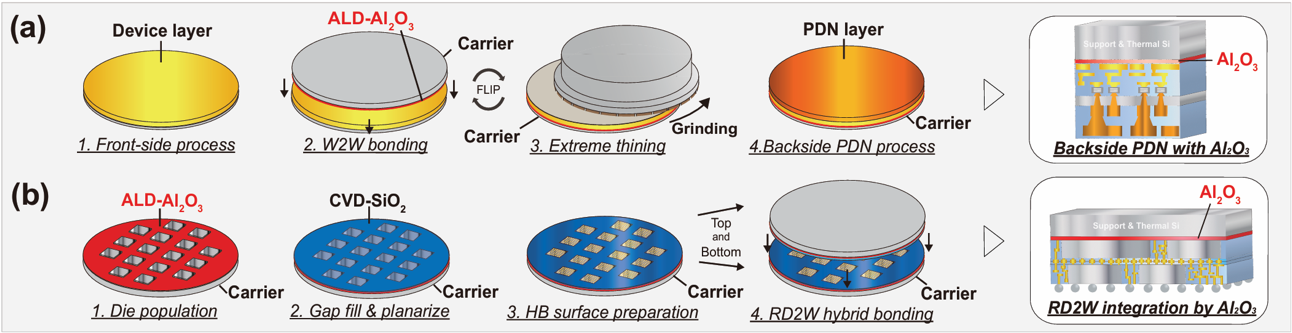
図1 今回提案する新規膜接合技術の模式図
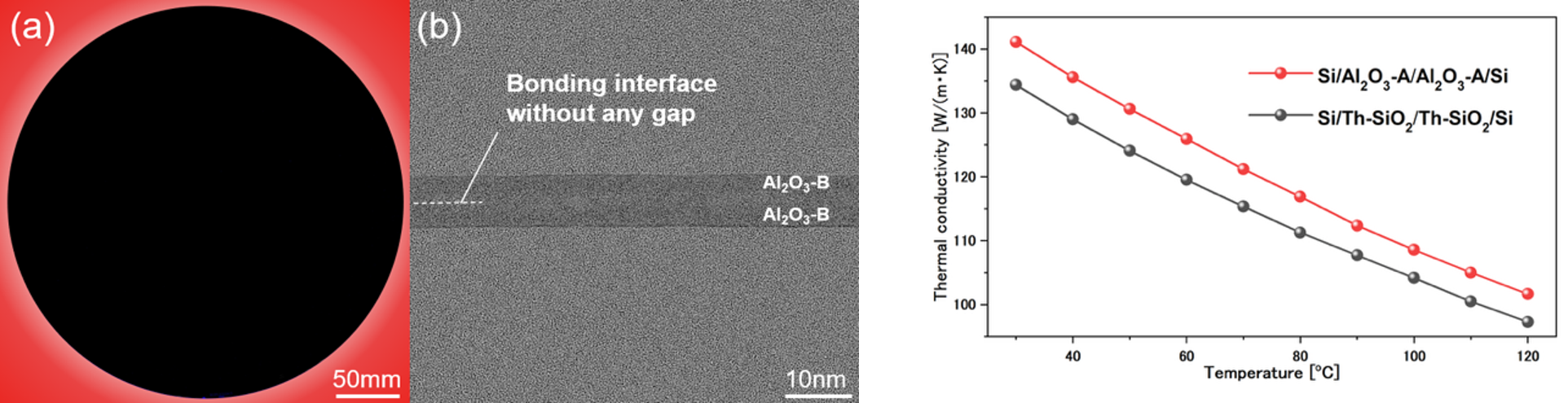
図2 300mmウェーハ上での接合実証および熱特性評価
今後も当社グループは、コーポレートスローガン「技術と対話で未来をつくる(Technology & Tai-wa for Tomorrow)」のもと、事業とESGの取り組み(環境・社会課題の解決、ガバナンスの強化)の両側面から経済価値および環境・社会価値を追求することで、SDGsの達成に寄与するとともに、持続可能な社会の実現と当社グループの持続的な発展の両立をめざします。
論文情報
学会名:28th International Interconnect Technology Conference (IITC2025)
論文タイトル:Novel Bonding Interfacial Material for Carrier Wafer of BSPDN & Reconstructed D2W Integration
発表者:Hayato Kitagawa1, Taisuke Yamamoto1, Jenyu Lee2, Shuntaro Machida2, Kazuhiro Yuasa2, Fumihiro Inoue1
1) YOKOHAMA National University, 2) KOKUSAI ELECTRIC CORPORATION